信息摘要:
在HDIPCB制板中,微孔加工和电镀工艺是两大核心制程,其技术难度和精度要求直接决定了产品的可靠性和性能。关键制程解析微孔加工H…
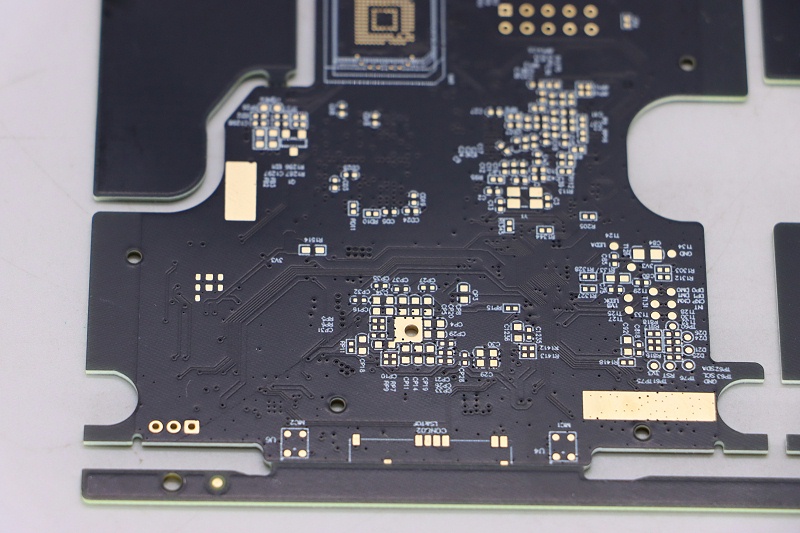
在HDI PCB制板中,微孔加工和电镀工艺是两大核心制程,其技术难度和精度要求直接决定了产品的可靠性和性能。
关键制程解析
微孔加工 HDI板的核心特征是通过激光钻孔技术制作微导通孔(孔径≤0.10mm),包括盲孔和埋孔结构。激光钻孔需控制激光功率、脉冲宽度等参数,若精度不足会导致孔壁粗糙或孔径偏差,影响层间互连的可靠性。
电镀工艺 微孔形成后需通过电镀实现金属化,确保导电性。高深径比微孔对电镀均匀性要求极高,需优化电镀液配比、添加剂(如整平剂)及工艺参数,避免孔内镀层不均匀或空洞。
技术挑战 微孔加工:激光钻孔需应对玻璃纤维与树脂烧蚀率差异导致的孔壁质量问题,机械钻孔则需解决高精度对位难题。
电镀工艺:填孔材料(如化学镀铜)的工艺复杂度高,需严格控制溶液浓度、温度等参数,以确保镀层质量。
综上,微孔加工与电镀工艺共同构成HDI制程的关键,二者协同决定了电路板的高密度互连能力和可靠性。